[拼音]:guangke
[外文]:photoetching
利用照相复制与化学腐蚀相结合的技术,在工件表面制取精密、微细和复杂薄层图形的化学加工方法。光刻原理虽然在19世纪初就为人们所知,但长期以来由于缺乏优良的光致抗蚀剂而未得到应用。直到20世纪50年代,美国制成高分辨率和优异抗蚀性能的柯达光致抗蚀剂(KPR)之后,光刻技术才迅速发展起来,并开始用在半导体工业方面。光刻是制造高级半导体器件和大规模集成电路的关键工艺之一,并已用于刻划光栅、线纹尺和度盘等的精密线纹。
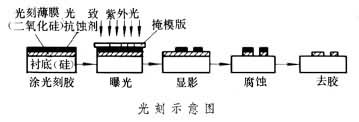
光刻的基本原理是:利用光致抗蚀剂(或称光刻胶)感光后因光化学反应而形成耐蚀性的特点,将掩模板上的图形刻制到被加工表面上。光刻半导体晶片二氧化硅的主要步骤(见图)是:
(1)涂布光致抗蚀剂;
(2)套准掩模板并曝光:③用显影液溶解未感光的光致抗蚀剂层;
(4)用腐蚀液溶解掉无光致抗蚀剂保护的二氧化硅层;
(5)去除已感光的光致抗蚀剂层。
光致抗蚀剂是一种对光敏感的高分子溶液,种类很多,根据光化学反应的特点一般可分为正性和负性两大类。凡用显影液能把感光的部分溶解去除的称为正性光致抗蚀剂;用显影液能把未感光的部分溶解去除的称为负性光致抗蚀剂。
光刻的精度很高,可达微米数量级,为使蚀刻线条清晰、边缘陡直、分辨率小于1微米的超微细图形,可采用远紫外曝光、X射线曝光、电子束扫描曝光,以及等离子体干法蚀刻等新技术。