[拼音]:zazhi fenbu celiang jishu
[外文]:measurement of impurity profiling
半导体器件的许多电学特性,包括结电容、串联电阻、击穿电压、穿通电压、电流增益、频率响应、开关速度等,都与形成器件的外延层、扩散层和离子注入层中的杂质分布有关。了解这些薄层中的杂质分布情况,无论对于设计高性能的器件,还是建立工艺过程的有效监控都具有重要意义。杂质分布测量有多种方法。
阳极氧化剥层与四探针测量法
用被测硅片作阳极,铂片作阴极,均置于电解液中,加上电压后在硅片的表面就会生成一层阳极氧化层。根据此氧化层的颜色,可粗略地控制其厚度为几百埃,再经椭圆仪精确测定为d1。然后,放入氢氟酸腐蚀液中除去氧化层,这样剥除的硅层厚度被折合为刅d1。刅为硅与它所生长二氧化硅的厚度比,通常约为0.43。在阳极氧化剥层前后,用四探针测量硅表面的薄层电阻,分别为Rs0和RS1。由此可得薄层电导的变化为1/Rs0-1/RS1=αd1(N1qμ)。式中q为电子电荷;μ为电子或空穴的迁移率,均为已知;N1为载流子浓度。在室温情况下杂质是充分电离的,也就是杂质浓度十分接近于N1。因此,可以把N1看成是阳极氧化所剥除的硅层内平均杂质浓度、也可视为距表面刅d1/2处的杂质浓度。经过这样连续的阳极氧化剥层与四探针测量,继续生长和剥除氧化层厚度 d2、d3、…、dn、…,测得薄层电阻Rs2、Rs3、…、Rsn、…,便可求得距表面 各点的杂质浓度N2、N3、…、Nn、…。这样,可测出整个薄层中的杂质分布。
各点的杂质浓度N2、N3、…、Nn、…。这样,可测出整个薄层中的杂质分布。
两探针测扩展电阻法
用两个金属探针与半导体表面接触。若半圆状针尖的半径均为ɑ,则在探针上加电压时绝大部分电压将降落在两针尖附近1.5ɑ范围以内。在小信号(小于15毫伏)情况下,电压U与流过探针的电流I 不论在正、反方向都呈线性关系。U/I称为扩展电阻,用Rs表示。Rs与ɑ成反比,与接触处半导体材料的电阻率ρ成正比,即Rs ρ/ɑ。对于一台固定的两探针装置(ɑ不变),首先用一套已知电阻率ρ和晶体取向的标准样片作Rs测量,并得出Rs~ρ 校准曲线。
ρ/ɑ。对于一台固定的两探针装置(ɑ不变),首先用一套已知电阻率ρ和晶体取向的标准样片作Rs测量,并得出Rs~ρ 校准曲线。
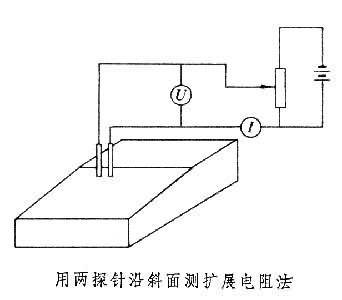
用两探针测量薄层的杂质分布时,须把样品事先磨成一个0.5~2°的小角度倾斜面。然后,使两探针平行于原始表面,并沿新的倾斜表面顺次测出Rs,用Rs~ρ校准曲线确定ρ、再由ρ换算出杂质浓度N。根据斜面的倾斜度,可以算出测量点新对应的磨角前样品的深度。这样就得出杂质浓度N 随深度的分布。 用两探针扩展电阻法测量杂质分布的优点是测量掺杂浓度范围宽,空间分辨率高,不论是同型层或异型层均适用。
电容-电压法
在PN结和金属-半导体接触的肖特基势垒中,改变外加反偏压即可改变空间电荷层的宽度,从而改变结电容。电容-电压关系与空间电荷层扩展处的杂质浓度有关。对于突变PN结和肖特基势垒,N可表示为

空间电荷层宽度与结电容的关系可表示为
W=εA/C
上式中的N 在突变PN结中为轻掺杂一侧空间电荷层边缘处的杂质浓度,在肖特基势垒中为空间电荷层向半导体内扩展的边缘处杂质浓度;q为电子电荷;ε为半导体材料的电容率;A为PN结或金属-半导体接触的面积;C为结电容;U为反向偏压;W 为空间电荷层宽度。测量杂质分布时,首先把所测的样片加工成台面PN结或肖特基势垒二极管,并精确测量其结面积A。测出在不同反偏压U时的电容C,给出1/C2~U曲线。空间电荷层扩展的边缘位置x,可表示为x=xj+W,在PN结中xj就是结深,在肖特基势垒中xj=0。根据这些情况,每选取一个反偏压U的数值就可以从1/C2~U曲线上求出d(1/C2)/du值。再由此计算出杂质浓度N 的数值,并由电容C计算出W 以及与杂质浓度N相对应的位置x。最后即得杂质浓度分布N~x。
用电容-电压法测量杂质分布,手续简便,能满足部分半导体器件性能分析的要求。但是,这种测量方法仅限于反映PN结轻掺杂一侧和肖特基势垒附近半导体中的杂质浓度,加之空间电荷层的扩展又要受到击穿电压的限制,因而所能测量的空间范围是很有限的。
离子探针分析
用一束能量为 5~20千电子伏的针状离子束轰击样品,使被轰击层中的原子溅射离化成离子,然后通过质量分析器辨别二次离子的成分。对样品进行逐层剥蚀分析,即可测出杂质分布。此法还可同时测定两种杂质元素的分布,并以10 ~10
~10 克的绝对灵敏度和10-6~10-9 的相对灵敏度测定微量成分,以1微米的空间分辨率和 50~100埃的深度分辨本领给出从氢到铀所有元素在三维空间的分布,还能测定同位素。
克的绝对灵敏度和10-6~10-9 的相对灵敏度测定微量成分,以1微米的空间分辨率和 50~100埃的深度分辨本领给出从氢到铀所有元素在三维空间的分布,还能测定同位素。
放射线同位素法
此法包括示踪原子法和中子活化法两种,利用放射性同位素由于核蜕变而发出的特征辐射进行定量检测,配合阳极氧化或化学去层就可测出杂质分布。它可测定0.001%~1%的相对杂质含量,以及10-4~10-8克的绝对含量。
(1)示踪原子法:把待研究杂质的放射性同位素作为杂质源按常规扩散工艺引入半导体中,然后逐层测量其放射性。放射性同位素要选择合适,半衰期长短适中,尽量采用具有β射线的同位素,因它易于防护且计数效率高。
(2)中子活化法:把已掺入杂质元素的半导体样品送到中子源前进行一定时间的辐照,然后取出进行逐层分析。常用的是把样品送到原子能反应堆中进行热中子辐照。
用四探针、两探针和电容-电压法所测的杂质浓度,都是经过测量电学参量换算得到的,实际上是半导体中已电离的那部分杂质浓度。而离子探针和放射性同位素法则是直接测得的全部杂质浓度,包括电离和未电离的两部分。这种方法不受同型层或异型层结构的限制,不仅能测半导体中的杂质浓度,而且能测二氧化硅等绝缘层中的杂质浓度。但由于这两种方法的测量手续繁杂,一般不用于常规测试。